
極端紫外線リソグラフィー実現のためには,多層膜反射型マスクの無欠陥化という技術課題が残っており,実用化される2007年までに大きさ30
nmの欠陥を高速に検査しなくてはなりません.そのためにマスクの強度欠陥および多層膜成膜に起因する位相欠陥を観察できるツールとして位相差極端紫外光顕微鏡の開発をすすめています.
倍率6000倍,分解能は横方向20 nm,高さ方向0.03 nmの立体X線像が得られるものを構築し,これにより多層膜の表面・界面の分析を進め,マスクの無欠陥化のための筋道を明らかにすることが目的です.
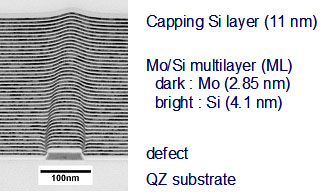
位相欠陥.従来のマスク検査法では検出できないこのような位相欠陥を観察することが目標です.
観察の様子.10秒程度秒でコントラストがあがります.


EUVL用マスク観察結果
H. Kinoshita, T. Haga, K. Hamamoto, S. Takada, N. Kazui, S. Kakunai, H. Tsubakino, T. Shoki, M. Endo and T. Watanabe
Actinic mask metrology for extreme ultraviolet lithography
J. Vac. Sci. Technol. B22(1) (2004) 264-267
T. Haga, H. Kinoshita, K. Hamamoto, S. Takada, N. Kazui, S. Kakunai, H. Tsubakino and T. Watanabe
Evaluation of Finishied EUVL Mask using a Mirau Intergerometric Microscope
Jpn. J. Appl. Phys. 42 (2003) 3771-3775
ご質問等はこちらまで
1984年から極端紫外線リソグラフィー(EUVL)に関する研究をすすめてきました.下図のシステムは1996年から日立中央研究所、ニコンとの共同研究として進め、1998年10月からはASETとの共同研究として開発を進めました。1999年の秋には最小線幅56 nmのパタン転写に成功しました.また,2001年には10 mm×10 mmの領域内に60 nmの最小線幅をもつ大面積露光に成功しました.
露光装置 (ETS-1) ETS-1による大面積露光パタン
木下博雄,渡邊健夫,浜本和宏,椿野晴繁
極端紫外線露光技術
材料 51, 9 (2002) 999-1004
極紫外リソグラフィー
木下博雄,渡邊健夫,浜本和宏
光学 31, 7 (2002) 524-531
K. Hamamoto, T. Watanabe, H. Hada, H. Komano and H. Kinoshita
Characteristics of Chemically Amplified Resist in EUV Lithography
J. Photopolym. Sci. Technol. 15, 3 (2002) 361-366
K. Hamamoto, T.
Watanabe, H. Tsubakino, H. Kinoshita, T. Shoki and M. Hosoya
Fine Pattern Replication by EUV Lithography
J. Photopolym. Sci. Technol. 14, 4 (2001) 567-572
H. Nii, H. Kinoshita, T. Watanabe, K. Hamamoto, H. Tsubakino and Y. Sugie
Performance of Cr mask for extreme Ultraviolet lithography
Proc. SPIE 4409 (2001) 681-686
H. Nii, H. Kinoshita, T. Watanabe, et al
Studies on EUV mask cleaning by dry and wet processes
Proc. SPIE 4409 (2001) 687-694
T. Watanabe, H. Kinoshita, H. Nii, Y. Li, et al
Development of the large field camera
J. Vac.Sci., Technol. B18(6) (2000) 2905-2910
H. Kinoshita, T. Watanabe
Current states of EUV lithography
J. Photopolm. Sci. Technol. 13, 3 (2000) 379-384
将来のIT産業では,1V以下の低駆動電力ならび数十GHzの高速処理が可能な電子デバイスの開発が見込まれている.2009年には32nm級の線幅を持つデバイスの量産が予定されている.さらに量子デバイス等では10nm以下の微細加工が要求されている.
数十ナノメートル以下の線幅は分子数個分に相当することから,分子1個に相当する線幅制御が課題となる.そこで光1個に対して高い効率で反応が進み,かつ照射エリアのみが自己組織化により反応が進むデジタルイメージングレジスト(DIR)の開発をおこなう必要がある.
極端紫外線リソグラフィ技術開発の中でで線幅ばらつき(LER)の低い,低アウトガスをもったレジストの評価をすすめてきたが,この研究成果をとおしてデジタルイメージングレジストの開発を進めています.
T. Watanabe, H. Kinoshita, H. Nii, K. Hamamoto, H. Hada, H. Komano and
S. Irie
Photo-induced oitgassing from the resist for extreme ultraviolet lithography by
the quardruple mass spectrometer
J. Vac. Sci. Technol. B19(3) (2001) 736-742
T. Watanabe, K.
Hamamoto, H. Kinoshita, H. Tsubakino, H, Hada, H. Komano, M. Endo and M Sasago
Resist Outgassing by EUV Irradation
J. Photopolym. Sci. Technol. 14, 4 (2001) 555-560.
ご質問等はこちらまで
波長13.5 nm 近傍のEUV光は物質の吸収が強く,屈折率が1に近いため,透過型のレンズを光学系に使用することはできません.そのため反射型の光学系が必要となりますが,収差の小さな直入射光学系は高い反射率を得る薄膜が存在しませんでした。そこで、それを改善する方法として2種類の光学超薄膜を交互に何十層も積層し,各層から反射される光の強めあいの干渉効果を利用した多層膜の開発がすすめられてきました.われわれは,EUVLに使用される光(13.5nm)で高い反射率を得られるMo/Siの多層膜の成膜をおこなっております.また,位相差極端紫外光顕微鏡で不可欠なビームスプリッタの製作もすすめています.マグネトロンスパッタ装置による多層膜成膜をおこなっています.
多層膜反射率の測定はNewSUBARU BL10でおこないます.Mo/Si多層膜によって直入射で60%以上の反射率が得られています.
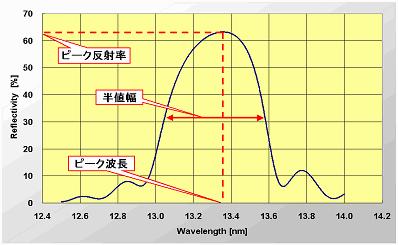
EUVLマスクの多層膜反射率
EUVリソグラフィーは真空中でおこないますが,露光を続けていくうちに,露光装置の光学系やマスクなどにコンタミネーション(主としてカーボン)が付着します.コンタミネーションは光学系反射率を低下させ,露光のスループットを低下させます.このコンタミネーション付着の原因としては,装置からでるガス,露光中にレジストから発生するアウトガス等があります.
現在当研究室では,コンタミネーションの問題に対し,
(1) コンタミネーション源となる,装置やレジストからのアウトガスを減らす
(2) 光学系に付着したコンタミネーションを除去する
ことを検討しています.とくに(2)に関しては,露光中に真空チャンバ内に酸素を流して除去する方法と,効率よくコンタミネーションを除去する方法としてXeエキシマランプからの172
nm光を使用する方法を提案しています.

マスクに付着したコンタミネーション.除去後には反射率は回復した.


ステンレス鋼からの脱ガス 熱収縮チューブからの脱ガス
装置内構成材料からの脱ガス量の比較
K. Hamamoto, S. Takada, T. Watanabe, N. Sakaya, T. Shoki, M. Hosoya and
H. Kinoshita
Investigation of Contamination Removal from Finished EUVL Mask
J. Photopolym. Sci. Technol. 16, 3 (2003) 395-400